各種高度の格子配列のパッケージの成長に対し、多くの後工程の挑戦が必要で
ある。
これらの配列からパッケージ単体を個片化することは製造工程での重要なステッ
プであり、多くの場合パッケージ全体コストの最小化に最も適合する必要がある。
品質を犠牲にせず生産性を増大させるあくなき要求に沿って、パッケージのサイ
ズを連続して縮小することで結果として、多くの格子配列パッケージをせん断/
抜き打ち技術からダイシング工程へと変化させた。パッケージサイズの縮小によ
り、下流のピック・アンド・プレースの組込みに影響を与えている。パッケージ
個片化の流れは多くのIPF(独立パッケージ組立業者)が世界中から中国へ移
動することを含め、組立ラインで中国の産業に重要なインパクトを持って期待さ
れている。
過去30年間ダイシングに関ってADT社はLTCC(Low Temperature
Co-fire Ceramic)パッケージ、Saw(Surf Acoustic Wave)デバイスパッケ
ージ、イメージセンサー用ウエーハレベルCSP(Chip Scale Package)、及
び多数の各種BGA(Ball Grid Array)及びQFN(Quad Frame No-lead)の
様な広汎なパッケージのダイシング業務に直面した顧客の個々の特有な工程開
発をして来た。
世界中で需要の高いQFNは、引き伸ばし易い(銅)且つ硬い(プラスチック
モールド)材料で構成される複雑な物質の優れた例で、パッケージサイズ縮小の
明解な流れと継続した品質スペックの厳しさを示す。世界中のQFNの需要は年
間10億個で年間増加率20〜30%が予想されている。この成長の一部はSO
IC(Small Outline Integrated Circuit)の犠牲もあるだろう。ADTはQ
FNを膨大な可能性のあるパッケージと認めており、ニーズを満たす総合ダイシ
ングプロセス解決策として過去3年以上お客様に提供し続けて来た。
BGA QFN

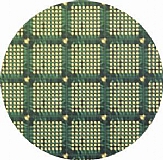
LTCC LEDパッケージング